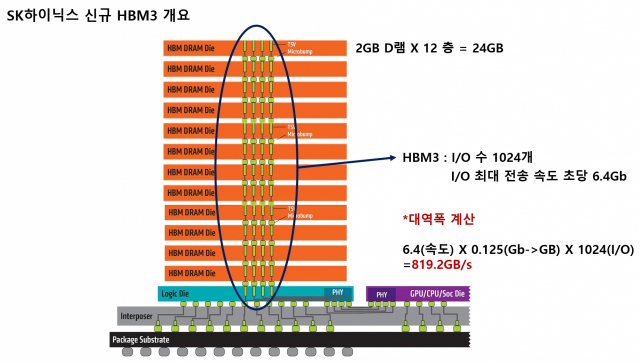
반도체 제조 과정에서 웨이퍼 내에서 멀티 레이어를 연결하는 기술은 **비아(via)**와 **MIV(Through-Silicon Via, TSV)**라고 부르며, 주로 웨이퍼 단계에서 레이어 간 연결을 이루는 기술입니다. 하지만 패키징에서 멀티 레이어를 구성하고 연결하는 방법은 다른 용어와 기술을 사용합니다.
패키징에서 멀티 레이어를 구성하는 주요 기술은 Fan-Out Wafer-Level Packaging (FOWLP), 2.5D 패키징, 3D 패키징입니다. 각 기술의 목적은 반도체 소자를 더 작게, 더 빠르게, 더 효율적으로 통합하는 것입니다.
1. Fan-Out Wafer-Level Packaging (FOWLP): 여러 다이(die)를 하나의 패키지에 집적하여 멀티 레이어로 구성하고, 패키지 외부로 배선을 넓혀 소형화와 성능을 향상시키는 기술입니다.
2. 2.5D 패키징: 인터포저(interposer)를 사용하여 여러 개의 다이를 연결하는 방식입니다. 이는 다이를 수평적으로 배치한 뒤 인터포저를 통해 다이와 다이 사이의 배선을 형성하며, 인터포저 자체는 여러 레이어로 구성됩니다.
3. 3D 패키징: 트루 3D 패키징이라고 불리며, **스택(stack)**을 쌓아 다이를 세로로 적층한 뒤 Through-Silicon Via (TSV) 기술을 이용해 다이 간에 직접 연결을 이루는 방식입니다. 3D 패키징은 더 높은 집적도와 빠른 신호 전송을 가능하게 합니다.
질문 : 여기서 말하는 다이 라는 것은 뭐지?
반도체 공정에서 **다이(die)**는 웨이퍼에서 개별적으로 잘라낸 작은 칩을 의미합니다. 다이는 반도체 소자가 실제로 구현된 실리콘 조각으로, 하나의 웨이퍼 위에 여러 개의 다이가 형성된 후, 웨이퍼를 절단하여 각 다이를 개별적으로 분리하게 됩니다.
간단히 말해서, 다이는 우리가 흔히 **칩(chip)**이라고 부르는 반도체 소자의 가장 기본 단위입니다. 예를 들어, CPU, GPU, 메모리 칩 등의 반도체 장치들은 각각 하나의 다이로 구성됩니다. 다이 안에는 트랜지스터, 저항, 캐패시터 등 수많은 전자 소자가 집적되어 특정한 기능을 수행하는 회로가 들어 있습니다.
웨이퍼에서 다이로 가는 과정:
1. 웨이퍼 제조: 반도체 소자는 큰 실리콘 원판인 웨이퍼 위에서 제조됩니다.
2. 패터닝과 공정: 웨이퍼 위에 여러 개의 다이가 들어갈 회로가 패터닝(photolithography) 공정을 통해 형성됩니다.
3. 절단(Dicing): 웨이퍼 공정이 끝나면, 이 웨이퍼를 작은 조각들로 나누어 개별 다이로 분리합니다.
4. 패키징: 다이를 보호하고 외부와 연결할 수 있도록 패키징 과정에서 외부 전극 및 보호 소재가 추가됩니다.
질문 : fowlp와 2.5D의 차이를 더 구체적으로 설명해줄 수 있어?7
**Fan-Out Wafer-Level Packaging (FOWLP)**와 2.5D 패키징은 모두 반도체 소자의 소형화와 성능 향상을 위한 패키징 기술이지만, 그 구조와 기술적인 차이에 따라 각각 다른 방식으로 구현됩니다. 두 기술을 비교해 더 구체적으로 설명하겠습니다.
1. Fan-Out Wafer-Level Packaging (FOWLP)
Fan-Out Wafer-Level Packaging은 웨이퍼 수준에서 패키징을 진행하는 기술로, **웨이퍼 레벨 패키징(WLP)**의 한 종류입니다. 이 기술의 핵심은 다이를 웨이퍼 밖으로 확장시키는 방식(fan-out)을 사용하여 배선을 넓히고, 더 많은 입출력(I/O)을 가능하게 하는 것입니다.
FOWLP 특징:
패키지 구조: 다이를 웨이퍼 수준에서 먼저 집적한 후, 그 주변에 **몰딩(compound)**을 통해 다이의 외곽을 확장합니다. 그 후, 다이와 몰딩 위에 금속 층을 증착하여 **재배선(Redistribution Layer, RDL)**을 형성합니다. RDL은 다이의 I/O 패드를 넓혀 더 많은 배선과 연결을 가능하게 합니다.
얇고 작은 패키지: FOWLP는 다이의 주변에 배선을 확장하기 때문에, 기존의 패키징보다 더 얇고 소형화된 패키지를 만들 수 있습니다.
패키지 내부에 기판이 없음: FOWLP는 기판을 사용하지 않으며, 다이를 직접 몰딩과 재배선층으로 연결하기 때문에 비용이 절감되고 성능이 향상될 수 있습니다.
전기적 성능 개선: I/O가 더 많은 배선을 허용하면서, 성능이 향상되고 전력 소모가 줄어듭니다.
FOWLP 사용 예시:
스마트폰 SoC 패키지에서 많이 사용되며, 소형화된 칩을 구현하는 데 적합합니다.
애플의 A 시리즈 칩에서 FOWLP 기술이 적용되었으며, 전력 효율성과 성능을 높이는 데 기여하고 있습니다.
---
2. 2.5D 패키징
2.5D 패키징은 여러 개의 반도체 다이를 **인터포저(Interposer)**라는 중간 층 위에 배치하여 다이 간의 연결을 효율적으로 이루는 기술입니다. 여기서 2.5D라는 명칭은, 다이가 서로 수평으로 배치된다는 점에서 2D 패키징의 특성을 가지고 있지만, 인터포저를 통해 다이 간에 연결을 형성하는 부분이 3D적인 성질을 지니기 때문에 붙여진 이름입니다.
2.5D 패키징 특징:
인터포저의 역할: 2.5D 패키징에서 핵심적인 역할을 하는 것은 인터포저입니다. 인터포저는 다이들이 배치되는 얇은 기판으로, 실리콘이나 유리로 만들어집니다. 다이들은 인터포저 위에 얹히고, 인터포저 내부에 형성된 배선을 통해 다이 간의 고속 통신이 이루어집니다.
Through-Silicon Via (TSV) 사용: 인터포저 내에서 다이 간의 연결을 위해 **TSV(Through-Silicon Via)**가 사용됩니다. TSV는 실리콘을 관통하는 미세 구멍을 통해 배선을 연결하는 기술로, 높은 전송 속도를 지원합니다.
다이 간 연결성: 인터포저 위에 배치된 여러 다이들이 수평으로 연결되기 때문에, 각각의 다이를 서로 다른 공정 기술로 제조할 수 있습니다. 예를 들어, 메모리 다이와 프로세서 다이를 서로 다른 공정에서 만든 후, 하나의 패키지에 집적할 수 있습니다.
복잡한 집적도: 인터포저 위에 여러 개의 다이를 배치할 수 있기 때문에 더 많은 기능을 하나의 패키지에 통합할 수 있습니다.
2.5D 패키징 사용 예시:
고성능 서버, 데이터 센터, AI 가속기, 그래픽 카드 등에서 주로 사용됩니다.
AMD의 Ryzen과 Radeon 시리즈에서 2.5D 패키징을 사용하여 여러 다이를 하나의 칩으로 통합한 사례가 있습니다.
Xilinx와 같은 FPGA에서 인터포저 기반 패키징을 사용하여 성능을 극대화하고 있습니다.
---
FOWLP와 2.5D 패키징의 주요 차이점:
구조:
FOWLP는 다이를 웨이퍼 외곽으로 확장시켜 재배선층을 만드는 반면, 2.5D 패키징은 인터포저를 통해 다이를 수평으로 배치하고 연결합니다.
I/O 확장 방식:
FOWLP는 재배선층(RDL)을 통해 I/O 수를 확장하고 연결을 형성하는 반면, 2.5D는 TSV를 통해 다이 간의 고속 연결을 지원합니다.
기판 사용 여부:
FOWLP는 기판이 없이 다이를 직접 몰딩 및 재배선으로 연결하지만, 2.5D는 인터포저 기판을 사용하여 다이 간의 연결을 형성합니다.
질문 : 인터포저는 웨이퍼에서 만드는거야?
네, **인터포저(Interposer)**는 보통 웨이퍼 제조 공정을 통해 만듭니다. 일반적으로 실리콘 웨이퍼나, 경우에 따라서는 유리 또는 세라믹 기판을 사용하여 제조되며, 반도체 소자 간의 연결을 담당하는 중요한 구성 요소입니다. 인터포저는 다이들 사이에서 전기적 신호를 전달하고, 패키징 과정에서 복잡한 배선을 단순화하는 역할을 합니다.
인터포저 제작 과정:
1. 실리콘 웨이퍼 사용: 대부분의 인터포저는 실리콘을 기본 소재로 사용합니다. 이는 기존 반도체 제조 공정과 호환되며, TSV(Through-Silicon Via)를 쉽게 구현할 수 있기 때문입니다. 이 실리콘 웨이퍼는 다이 사이의 전기 신호 전달을 위한 배선층을 포함하게 됩니다.
2. TSV(Through-Silicon Via) 형성: TSV는 실리콘 인터포저에 미세한 구멍을 뚫고, 그 구멍을 통해 **전도성 물질(보통 구리)**을 채워넣어 상단의 다이와 하단의 다이 또는 패키지 기판 간에 전기적 연결을 형성합니다. 이 과정을 통해 상하단 층 사이에 고속으로 신호를 주고받을 수 있습니다.
3. 배선층 형성: 인터포저의 상부 및 하부에는 다이와 연결되는 **배선 층(RDL, Redistribution Layer)**이 형성됩니다. 이 배선층은 다이 간의 신호 경로를 형성하여 다이들이 서로 통신할 수 있게 해줍니다. 이로써 인터포저는 단순한 기판 이상의 역할을 수행하며, 다이 간의 효율적인 통신을 가능하게 합니다.
4. 다이 부착: 이후 제조된 인터포저 위에 여러 개의 **다이(die)**를 배치하고, 다이와 인터포저 사이를 플립 칩 본딩(flip-chip bonding) 등의 기술을 이용해 연결합니다.
인터포저의 주요 소재:
실리콘 인터포저: 가장 흔히 사용되며, TSV와 쉽게 통합될 수 있습니다. 실리콘은 반도체 제조에 익숙한 재료이기 때문에 이 방식이 가장 보편적입니다.
유리 또는 세라믹 인터포저: 유리나 세라믹도 사용할 수 있으며, 특정한 전기적 특성(예: 낮은 유전 상수)을 필요로 할 때 사용됩니다. 하지만, 실리콘 인터포저에 비해 상대적으로 덜 사용됩니다.
인터포저 사용의 장점:
다이 간 고속 통신: 인터포저는 다이 간의 신호 지연을 최소화하고, 높은 대역폭의 통신을 지원할 수 있습니다.
이종 집적 가능: 2.5D 패키징에서는 서로 다른 공정에서 제조된 다이들을 하나의 패키지에 통합할 수 있는데, 인터포저가 이 다이들을 효과적으로 연결해 줍니다.
고밀도 배선: 인터포저는 고밀도의 배선을 지원하여, 복잡한 회로를 소형 패키지에 통합할 수 있습니다.